www.industrieweb.fr
01
'26
Written on Modified on
ZEISS améliore la précision FIB-SEM avec Crossbeam 750
Le nouveau système combine l’imagerie SEM en temps réel et le fraisage FIB avec l’optique Gemini 4 pour améliorer la précision du point final et les flux de travail d’analyse 3D.
www.zeiss.com
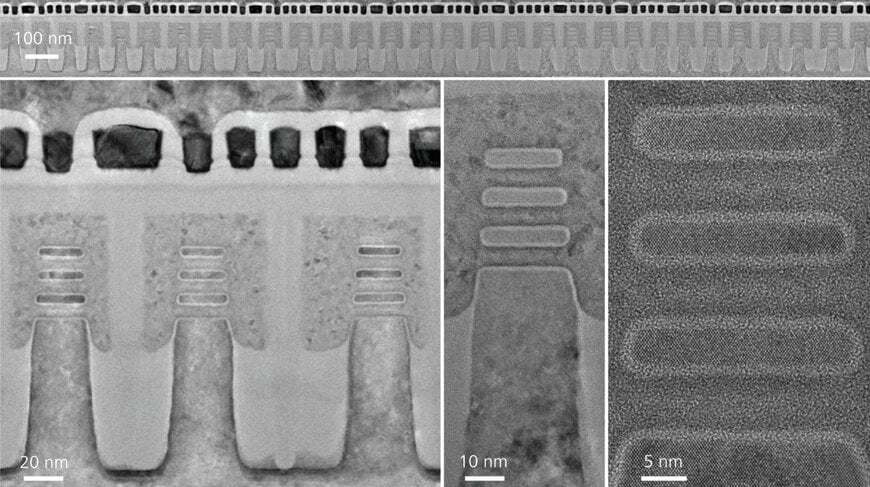
L’analyse des semi-conducteurs, la science des matériaux et les processus de nanofabrication nécessitent une préparation d’échantillons précise, une imagerie haute résolution et une détection exacte du point final à l’échelle nanométrique. Dans ce contexte, ZEISS a introduit le Crossbeam 750 FIB-SEM, conçu pour permettre un fraisage simultané par faisceau d’ions focalisé (FIB) et une imagerie par microscopie électronique à balayage (SEM), assurant un contrôle continu du processus pendant la préparation des échantillons.
Le système intègre l’imagerie en temps réel aux opérations de fraisage, permettant aux utilisateurs de surveiller l’élimination du matériau et l’évolution structurelle sans interrompre le processus. Cette approche répond à une limitation clé des flux de travail FIB-SEM conventionnels, où l’imagerie intermittente peut entraîner des imprécisions dans la détection du point final et une augmentation des reprises.
Contrôle de processus en temps réel « voir pendant le fraisage »
Le Crossbeam 750 permet une imagerie SEM continue dans toutes les conditions de fraisage, de l’enlèvement de matière à courant élevé au polissage fin à de faibles tensions d’accélération jusqu’à 0,5 kV. Cette capacité permet aux opérateurs d’observer directement les interactions FIB–échantillon et d’ajuster les paramètres en temps réel.
Ce niveau de contrôle est particulièrement pertinent dans la préparation de lamelles pour la microscopie électronique en transmission (TEM), où une épaisseur uniforme et des dommages minimaux sont requis. En maintenant la visibilité tout au long du processus, le système favorise la réussite dès le premier passage dans la fabrication des lamelles et réduit le besoin de corrections itératives.
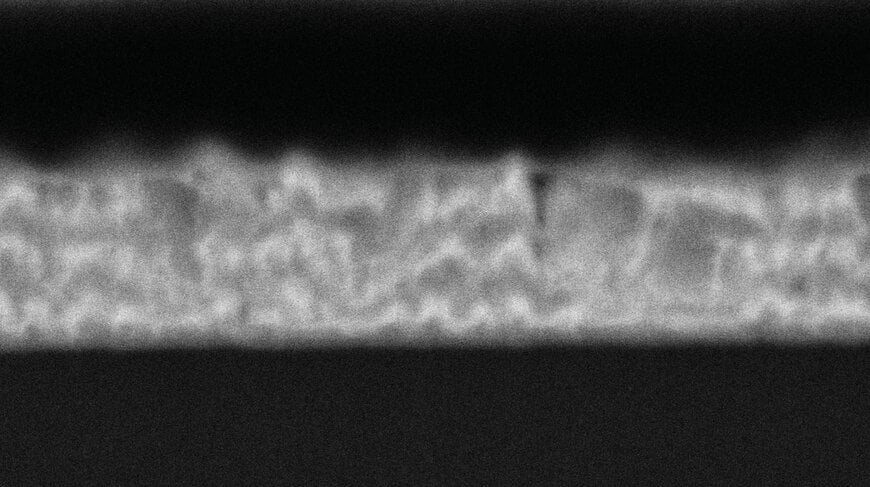
Optique Gemini 4 pour une imagerie haute résolution
Le système intègre la nouvelle optique électronique Gemini 4, qui offre une résolution améliorée et un meilleur rapport signal/bruit. Cela permet une imagerie sans arrière-plan et des performances stables à faibles énergies d’atterrissage, ce qui est essentiel pour les matériaux sensibles et les analyses de haute précision.
Les performances d’imagerie améliorées prennent en charge des applications nécessitant une caractérisation structurelle détaillée, y compris les dispositifs semi-conducteurs avancés et les systèmes de matériaux à l’échelle nanométrique.
Applications dans les flux de travail avancés des semi-conducteurs et des matériaux
Le Crossbeam 750 est conçu pour une utilisation dans des applications de semi-conducteurs de nœuds avancés, y compris les dispositifs logiques et mémoire basés sur des architectures telles que gate-all-around (GAA) et les FET complémentaires (CFET). Ces structures nécessitent une précision à l’échelle nanométrique lors du sectionnement et de l’amincissement des échantillons.
Au-delà des semi-conducteurs, le système prend en charge une gamme d’applications en science des matériaux et en sciences de la vie, notamment :
- Préparation de lamelles TEM pour la microscopie haute résolution
- Préparation d’échantillons pour la tomographie par sonde atomique (APT)
- Processus de nanofabrication tels que la lithographie par faisceau d’électrons
- Imagerie volumique tridimensionnelle (3D) et tomographie
Le grand champ de vision sans distorsion du système améliore la qualité des données en tomographie 3D, tandis que des conditions d’imagerie stables à faible kV améliorent le contraste et réduisent le temps d’acquisition.

Amélioration du débit et de la reproductibilité
En éliminant la nécessité d’interrompre le fraisage pour l’imagerie, le Crossbeam 750 rationalise les flux de travail et réduit le temps total de traitement. La surveillance continue permet des résultats plus cohérents, en particulier dans les environnements à haut débit où la reproductibilité est essentielle.
La capacité à atteindre des points finaux précis dès la première tentative est particulièrement précieuse dans l’analyse des défaillances des semi-conducteurs et le développement des procédés, où des écarts à l’échelle nanométrique peuvent affecter les performances des dispositifs.
Positionnement au sein des systèmes FIB-SEM
Les plateformes FIB-SEM sont largement utilisées pour la préparation et l’analyse d’échantillons à l’échelle nanométrique. Des systèmes comparables incluent la série Helios de Thermo Fisher Scientific et les plateformes FERA de Tescan, qui combinent également le fraisage par faisceau d’ions avec l’imagerie électronique.
Les principaux facteurs de différenciation dans ce segment incluent la résolution d’imagerie à basse tension, la visibilité du processus en temps réel et la qualité du champ de vision pour la reconstruction 3D. L’intégration de l’imagerie SEM continue pendant le fraisage et de l’optique électronique améliorée du Crossbeam 750 cible ces paramètres de performance, en particulier pour les nœuds semi-conducteurs avancés et la recherche sur les matériaux de haute précision.
En combinant imagerie et fraisage simultanés avec des performances optiques améliorées, le Crossbeam 750 répond aux exigences évolutives de la fabrication et de l’analyse à l’échelle nanométrique, où le contrôle du processus et la fidélité de l’imagerie ont un impact direct sur les résultats.
Édité par Natania Lyngdoh, éditrice Induportals — Adapté par IA.
www.zeiss.com

Amélioration du débit et de la reproductibilité
En éliminant la nécessité d’interrompre le fraisage pour l’imagerie, le Crossbeam 750 rationalise les flux de travail et réduit le temps total de traitement. La surveillance continue permet des résultats plus cohérents, en particulier dans les environnements à haut débit où la reproductibilité est essentielle.
La capacité à atteindre des points finaux précis dès la première tentative est particulièrement précieuse dans l’analyse des défaillances des semi-conducteurs et le développement des procédés, où des écarts à l’échelle nanométrique peuvent affecter les performances des dispositifs.
Positionnement au sein des systèmes FIB-SEM
Les plateformes FIB-SEM sont largement utilisées pour la préparation et l’analyse d’échantillons à l’échelle nanométrique. Des systèmes comparables incluent la série Helios de Thermo Fisher Scientific et les plateformes FERA de Tescan, qui combinent également le fraisage par faisceau d’ions avec l’imagerie électronique.
Les principaux facteurs de différenciation dans ce segment incluent la résolution d’imagerie à basse tension, la visibilité du processus en temps réel et la qualité du champ de vision pour la reconstruction 3D. L’intégration de l’imagerie SEM continue pendant le fraisage et de l’optique électronique améliorée du Crossbeam 750 cible ces paramètres de performance, en particulier pour les nœuds semi-conducteurs avancés et la recherche sur les matériaux de haute précision.
En combinant imagerie et fraisage simultanés avec des performances optiques améliorées, le Crossbeam 750 répond aux exigences évolutives de la fabrication et de l’analyse à l’échelle nanométrique, où le contrôle du processus et la fidélité de l’imagerie ont un impact direct sur les résultats.
Édité par Natania Lyngdoh, éditrice Induportals — Adapté par IA.
www.zeiss.com

